2025/02/07
1224
大功率LED封装技术全面解析 - 光亚照明展
2025广州光亚展于2025年6月9日至6月12日在中国进出口商品交易会展馆举行,邀您关注广州国际照明展览会今日资讯:
因其独特的结构与复杂的工艺,对LED的性能与寿命产生直接影响,从而成为了近年来科研领域的重点研究对象,尤其以大功率白光LED封装为研究核心。LED封装的主要功能涵盖四个方面:首先是机械保护,旨在提升产品的稳定性;其次是散热强化,通过降低晶片结温来提升LED的性能;再者是光学调控,旨在提高光线输出效率并优化光束分布;最后是供电管理,涵盖交流与直流的转换以及电源控制等关键环节。
LED封装的选择,涵盖方法、材料、结构和工艺等多个方面,这些选择主要受到晶片结构、光电/机械特性、具体应用场景以及成本因素的共同影响。历经40余年的发展与演变,LED封装已从早期的支架式(Lamp LED)和贴片式(SMD LED),逐步演进到现今的高功率型LED(Power LED)阶段。随着晶片功率的不断提升,特别是固态照明技术的迅猛发展,对LED封装在光学、热学、电学以及机械结构等方面的要求也日益严苛。为了有效降低封装热阻并提升出光效率,全新的技术思路和设计方法成为必需。
大功率LED封装涉及的关键技术广泛,包括光、热、电等多方面因素。其中,光是LED封装的最终目标,热管理是核心挑战,而电、结构与工艺则是实现这一目标的重要手段。性能的优劣则直接反映了封装技术的水平。从工艺相容性和成本控制的角度出发,LED封装设计应与晶片设计同步进行,以确保封装结构和工艺的合理性与可行性。否则,可能会因封装需求而对晶片结构进行不必要的调整,从而延长研发周期并增加工艺成本。
在低热阻封装工艺方面,由于LED光效的提升意味着输入电能的大部份将转化为热量,而LED晶片面积相对较小,因此散热问题成为封装过程中的关键挑战。这涉及到晶片的合理布置、封装材料的选择与工艺优化、以及热沉设计等多个环节。
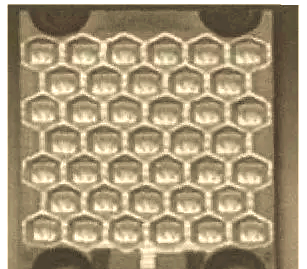
LED封装的热阻主要包括由材料(如散热基板和热沉结构)产生的内部热阻以及介面热阻。散热基板的任务是吸收晶片释放的热量,并将其传导至热沉,从而实现与外界的热交换。常用的散热基板材料包括矽、金属(例如铝和铜)、陶瓷(例如Al2OAIN、Sic)以及复合材料等。例如,Nichia公司采用CuW作为衬底,将1mm晶片倒装其上,从而降低了封装热阻,提升了发光功率和效率。另一方面,Lamina Ceramics公司则开发了一种低温共烧陶瓷金属基板及其相应的LED封装技术。该技术首先制备出适合共晶焊的大功率LED晶片和陶瓷基板,然后将晶片与基板直接焊接。由于该基板集成了共晶焊层、静电保护电路、驱动电路及控制补偿电路,且材料热导率高、热介面少,因此大大提升了散热性能,为高功率LED阵列封装提供了解决方案。此外,德国Curmilk公司研制的高导热性覆铜陶瓷板,通过高温高压烧结陶瓷基板(AIN和Al2O3)与导电层(Cu)而成,无需使用黏结剂,因此具有出色的导热性、高强度以及绝缘性。其中,氮化铝(AIN)的热导率为160W/mk,热膨胀系数与硅相近,从而降低了封装热应力。
研究还揭示,封装介面对热阻的影响亦不容忽视。若介面处理不当,即便在室温下接触良好的介面也可能在高温下产生间隙,而基板的翘曲则可能影响键合和局部散热。因此,减少介面和介面接触热阻、增强散热成为改善LED封装的关键。在此背景下,选择适当的热介面材料(TIM)显得尤为重要。常用的TIM包括导电胶和导热胶,但因其热导率较低(一般为5-5W/mK),导致介面热阻偏高。相比之下,采用低温和共晶焊料、焊膏或内掺纳米颗粒的导电胶作为热介面材料,可显著降低介面热阻。
高取光率封装结构与工艺
在LED的应用过程中,光线从晶片发出时面临多种损失。这些损失主要源于晶片内部的结构缺陷和材料吸收,出射界面的折射率差异导致的反射损失,以及入射角超过全反射临界角引发的全反射损失。因此,相当一部分光线无法有效从晶片中出射到外部。为了减少这些损失并提高取光效率,通常会在晶片表面覆盖一层高折射率的透明胶层,即灌封胶。这层胶位于晶片与空气之间,能够显著降低光子在界面处的损失。此外,灌封胶还扮演着对晶片进行机械保护、应力释放以及作为光导结构的角色。因此,它需要具备高透光率、高折射率、良好的热稳定性、适宜的流动性以及易于喷涂的特性。
为了进一步提升LED封装的可靠性,灌封胶还需具备低吸湿性、低应力以及耐老化等特性。目前市场上常用的灌封胶主要包括环氧树脂和矽胶。尽管环氧树脂也具有一定的透光性和热稳定性,但其性能仍不及矽胶。矽胶因其高透光率、大折射率、出色的热稳定性、低应力以及低吸湿性等特点,在大功率LED封装领域得到了广泛应用,尽管其成本相对较高。研究显示,通过提高矽胶的折射率,可以更有效地减少因折射率物理屏障导致的光子损失,进而提升外量子效率。然而,需要注意的是,矽胶的性能会受到环境温度的影响。随着温度的升高,矽胶内部的热应力会逐渐增大,导致其折射率有所降低,从而对LED的光效和光强分布产生一定影响。
萤光粉在LED封装中扮演着光色复合的重要角色
其特性涵盖粒度、形状、发光效率、转换效率以及热和化学稳定性等多个方面。其中,发光效率和转换效率是决定LED性能的关键因素。然而,随着温度的升高,萤光粉的量子效率会逐渐降低,导致出光减少,同时辐射波长的变化也会影响白光LED的色温和色度。此外,高温环境还会加速萤光粉的老化过程。这主要是因为萤光粉涂层由环氧或矽胶与萤光粉混合而成,其散热性能不佳,容易受到紫光或紫外光的辐射影响而发生温度猝灭和老化。
另外,灌封胶与萤光粉间折射率的不匹配以及萤光粉颗粒尺寸远大于光散射极限的问题,也会在萤光粉颗粒表面产生光散射,进而降低出光效率。为了解决这一问题,可以在矽胶中掺入纳米萤光粉,以提高折射率并降低光散射,从而提高LED的出光效率。同时,这也能够有效地改善光色质量。
在传统的萤光粉涂敷方式中,由于无法精确控制涂敷厚度和形状,往往会导致出射光色彩的不一致。为了解决这一问题,Lumileds公司开发了保形涂层技术,能够实现萤光粉的均匀涂覆,确保光色的均匀性。然而,当萤光粉直接涂覆在晶片表面时,由于光散射的存在,出光效率仍然较低。针对这一问题,美国Rensselaer研究所提出了光子散射萃取工艺,通过在晶片表面布置聚焦透镜并配合含萤光粉的玻璃片,不仅提高了器件的可靠性,还显著提高了光效。
总体而言,为了进一步提升LED的出光效率和整体可靠性,封装胶层正逐渐被高折射率透明玻璃或微晶玻璃等材料所替代。
通过将萤光粉内嵌或外涂于玻璃表面,不仅显著提升了萤光粉的均匀分布,同时也优化了封装流程。另外,通过减少LED出光方向的光学界面数量,也是有效提升出光效率的重要手段。
在过去的40多年里,LED封装技术和结构已经历了四个不同的阶段。
引脚式(Lamp)LED封装
引脚式封装,即A3-5mm封装结构,是LED封装中的一种常见形式。它适用于电流较小(20-30mA)且功率较低(小于1W)的LED。这种封装方式主要用于仪表显示或指示,也可在大规模集成时作为显示幕使用。然而,其缺点在于封装热阻较大(通常超过100K/W),导致寿命相对较短。
表面组装(贴片)式(SMT-LED)封装
表面组装技术(SMT)是一种将封装好的器件直接贴、焊到PCB表面指定位置的封装方法。通过特定工具或设备,将晶片引脚对准预先涂覆了粘接剂和焊膏的焊盘上,然后贴装到未钻安装孔的PCB上。经过波峰焊或再流焊后,建立起器件与电路之间的可靠机械和电气连接。SMT技术以其高可靠性、优异的高频特性以及易于实现自动化等优点,在电子行业中得到广泛应用。
板上晶片直装式(COB)LED封装
COB是Chip On Board的缩写,意为板上晶片直装。它通过粘胶剂或焊料将LED晶片直接粘贴到PCB板上,并通过引线键合实现电互连。PCB板材料可以是低成本的FR-4,也可以是高热导的金属基或陶瓷基复合材料。引线键合可以采用高温热超声键合或常温超声波键合。COB技术特别适用于大功率多晶片阵列的LED封装,相比SMT技术,它显著提高了封装功率密度并降低了热阻。
系统封装式(SiP)LED封装
系统封装式LED封装是一种更高级的封装方式。它将多个LED芯片与驱动电路、控制电路等集成在一起,形成一个完整的功能模块。这种封装方式不仅简化了设计过程,还提高了产品的整体性能和可靠性。然而,由于其复杂性较高,目前主要应用于高端产品中。
SiP(System in Package)是近年来为适应整机便携化和小型化趋势而发展起来的新型封装集成技术。它基于系统晶片(System on Chip,SOC)的概念,通过在一个封装内整合多个发光晶片以及电源、控制电路等不同器件,构建出功能更为全面的系统。相比其他封装结构,SiP具有工艺兼容性好、集成度高、成本低廉、易于分块测试和开发周期短等显著优势。此外,根据技术类型的不同,SiP还可进一步细分为晶片层叠型、模组型、MCM型和三维(3D)封装型等多种类型。
当前,高亮度LED器件正面临替代白炽灯和高压汞灯的挑战,这要求其必须具备更高的总光通量。光通量的提升可以通过增强集成度、增大电流密度或采用大尺寸晶片等方式实现。然而,这些措施同时也带来了功率密度的增加,从而对散热提出了更为严苛的要求。散热不良将导致LED晶片结温上升,进而影响其性能和寿命。多晶片阵列封装是当前提升光通量的有效途径,但面临价格、空间利用率、电气连接及散热等多重挑战。
针对紫光晶片的高密度集成和散热问题,必须采用高效的热沉结构和适当的封装工艺。被动散热方案通常采用高肋化系数的翅片,通过自然对流将热量散发到环境中,其结构简单、可靠性高,但适用于低功率密度和低集成度的情况。对于大功率LED封装,则需采用主动散热措施,如翅片加风扇、热管、液体强迫对流等,以确保LED的稳定性和寿命。
接下来,我们将对COB封装技术与SMD封装技术进行详细对比。
COB封装技术在LED显示屏应用领域已逐渐成熟,特别是在户外小间距显示方面,其独特的技术优势使得该技术脱颖而出。近年来,随着生产技术和工艺的持续改进,COB封装已取得了显著的进步,许多先前困扰其发展的难题也在技术创新中得到了有效解决。
那么,究竟COB封装技术的优势何在?它与传统的SMD封装技术相比有何不同?未来,COB封装技术是否有望成为LED显示屏行业的新主流,进而取代SMD封装技术呢?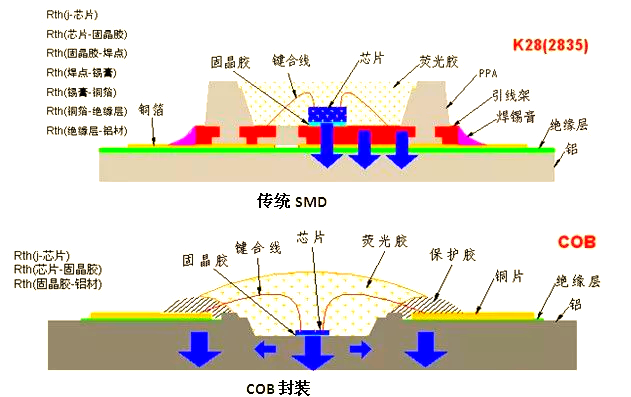
技术比较
COB封装技术涉及将LED芯片直接通过导电胶和绝缘胶固定在PCB板的灯珠灯位焊盘上,随后进行导通性能的焊接。在测试确认无误后,使用环氧树脂胶进行包封。
相比之下,SMD封装则是将LED芯片固定在灯珠支架的焊盘上,同样经过导通性能的焊接和测试。但随后,它还需要进行分光、切割、打编带等额外工序,并运输至屏厂等后续环节。
优劣势分析
SMD封装技术在制造高质量灯珠方面表现出色,但生产工艺的复杂性也导致了成本的相对提高。此外,从灯珠封装厂到屏厂之间的运输、物料仓储以及质量管控都增加了成本负担。
然而,SMD封装也面临着一些挑战。他们认为COB封装技术过于复杂,产品的一次通过率难以控制,甚至被视为难以逾越的技术障碍。此外,失效点的维修问题以及低成品率也是他们不得不面对的现实。
相比之下,SMD这种单灯珠单体化封装技术已经积累了多年的实战经验,各家厂商都拥有独特的技术和规模优势,使得技术实现相对容易。
COB封装则是一项全新的多灯珠集成化封装技术。在实践过程中,它需要在生产设备、工艺装备以及测试检测手段等方面不断进行创新和验证。虽然技术门槛高、难度大,但正是这样的挑战推动了技术的不断进步。目前,提高产品的一次通过率成为了COB封装面临的最大难题,但这也是行业发展的必经之路。
再来看SMD封装中使用的四角或六角支架,虽然为生产带来了便利,但也带来了技术困难和可靠性隐患。例如,灯珠面过回流焊时需要解决大量支架管脚的焊接良率问题。若要应用到户外环境,还需进一步解决支架管脚的户外防护问题。
相比之下,COB技术由于省去了支架环节,简化了后续生产流程,从而降低了技术困难和可靠性隐患。尽管面临诸如IC驱动芯片面过回流焊时的失效点问题以及模组墨色一致性等挑战,但这些技术丘陵并非不可攀登。随着技术的不断进步和创新,这些问题正逐步得到解决。
综上所述,COB封装技术在简化生产流程、降低技术困难和提升可靠性方面展现出了显著优势。尽管面临一些技术挑战,但行业的发展趋势正逐步向COB封装技术倾斜。未来,我们有理由期待COB封装技术能在LED显示屏领域发挥更大的潜力。
从封装开始,直至显示屏制造完成,COB封装技术实现了LED显示屏产业链中下游环节的深度整合。这一技术使得所有生产流程都在一个工厂内完成,简化了生产组织形式,优化了流程,并显著提高了生产效率。同时,这也为全自动化生产布局和产品质量管控提供了有力支持。
在产品研发阶段,COB封装技术就已全面考虑了各生产环节可能遇到的问题,并制定了相应的技术实施方案。这种前瞻性的设计思路,使得产品能够更好地满足终端客户的需求,并为其承担品质责任。
然而,COB封装技术在LED显示领域面临的最大挑战集中在灯珠的封装环节。尽管这是一座技术高峰,但并非不可攀登。它需要综合运用多种技术,经过无数次的失败和经验积累,才能成功突破。一旦越过这一技术障碍,整个生产环节将变得相对简单,再无其他重大技术难题。
相比之下,SMD封装技术在显示屏产业链中则面临着更为复杂的情况。封装企业和显示屏企业是两类独立的企业,它们共同分享产业利润。但由于生产组织形式的复杂性,导致产业利润被稀释,企业间竞争激烈,产品质量管控难度加大。此外,由于封装环节和显示屏厂环节的相对独立,使得针对生产过程中的技术难题难以有效协同攻关。一旦终端客户使用产品出现质量问题,责任追溯变得复杂且困难。
制造业的智能化转型已成为必然趋势,而传感器技术则是其关键支撑。同样,互联网的未来发展也离不开物联网的普及,而传感器无疑是物联网的基石。
文章来源:百度
广州国际照明展览会将展示多元化照明和LED技术方案,满足业内人士在采购、交流市场资讯和拓展商机方面的需求。展会更多资讯,详情请登陆官网 https://gile.gymf.com.cn
扫码实名预约,领取入场证!

| 凡本网注明“来源:广州光亚法兰克福展览有限公司”的所有作品,版权均属于广州光亚法兰克福展览有限公司,转载请注明。 凡注明为其它来源的信息,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点及对其真实性负责。若作者对转载有任何异议,请联络本网站,联系方式:020-89816057;我们将及时予以更正。 |


照明及LED产业风向标
欢迎莅临广州国际照明展览会!
主办单位官方微信









